单晶硅是信息产业中重要的基础材料.通常用炭在高温下还原二氧化硅制得粗硅(含铁、铝、硼、磷等杂质),粗硅与氯气反应生成四氯化硅(反应温度450~500℃),四氯化硅经提纯后用氢气还原可得高纯硅.以下是实验室制备四氯化硅的装置示意图.g-|||-连接-|||-尾气-|||-处理-|||-装置-|||-液-|||-A B D相关信息如下:①四氯化硅遇水极易水解;②硼、铝、铁、磷在高温下均能与氯气直接反应生成相应的氯化物;③有关物质的物理常数见下表: 物质 SiCl4 BCl3 AlCl3 FeCl3 PCl5 沸点/℃ 57.7 12.8 - 315 - 熔点/℃ -70.0 -107.2 - - - 升华温度/℃ - - 180 300 162 请回答下列问题:(1)写出装置A中发生反应的离子方程式 ____ .(2)装置A中g管的作用是 ____ ;装置C中的试剂是 ____ ;装置E中的h瓶需要冷却的理由是 ____ .(3)装置E中h瓶收集到的粗产物可通过精馏(类似多次蒸馏)得到高纯度四氯化硅,精馏后的残留物中,除铁元素外可能还含有的杂质元素是 ____ (填写元素符号).(4)为了分析残留物中铁元素的含量,先将残留物预处理,使铁元素还原成Fe2+,再用KMnO4标准溶液在酸性条件下进行氧化还原滴定,反应的离子方程式是:5Fe2++MnO4-+8H+=5Fe3++Mn2++4H2O①滴定前是否要滴加指示剂? ____ (填“是”或“否”),请说明理由 ____ .②某同学称取5.000g残留物后,经预处理后在容量瓶中配制成100mL溶液,移取25.00mL试样溶液,用1.000×10-2 mol/LKMnO4标准溶液滴定.达到滴定终点时,消耗标准溶液20.00mL,则残留物中铁元素的质量分数是 ____ .
单晶硅是信息产业中重要的基础材料.通常用炭在高温下还原二氧化硅制得粗硅(含铁、铝、硼、磷等杂质),粗硅与氯气反应生成四氯化硅(反应温度450~500℃),四氯化硅经提纯后用氢气还原可得高纯硅.以下是实验室制备四氯化硅的装置示意图.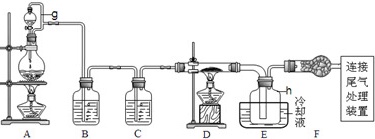
相关信息如下:①四氯化硅遇水极易水解;
②硼、铝、铁、磷在高温下均能与氯气直接反应生成相应的氯化物;
③有关物质的物理常数见下表:
| 物质 | SiCl4 | BCl3 | AlCl3 | FeCl3 | PCl5 |
| 沸点/℃ | 57.7 | 12.8 | - | 315 | - |
| 熔点/℃ | -70.0 | -107.2 | - | - | - |
| 升华温度/℃ | - | - | 180 | 300 | 162 |
(1)写出装置A中发生反应的离子方程式 ____ .
(2)装置A中g管的作用是 ____ ;装置C中的试剂是 ____ ;
装置E中的h瓶需要冷却的理由是 ____ .
(3)装置E中h瓶收集到的粗产物可通过精馏(类似多次蒸馏)得到高纯度四氯化硅,精馏后的残留物中,除铁元素外可能还含有的杂质元素是 ____ (填写元素符号).
(4)为了分析残留物中铁元素的含量,先将残留物预处理,使铁元素还原成Fe2+,再用KMnO4标准溶液在酸性条件下进行氧化还原滴定,反应的离子方程式是:5Fe2++MnO4-+8H+=5Fe3++Mn2++4H2O
①滴定前是否要滴加指示剂? ____ (填“是”或“否”),请说明理由 ____ .
②某同学称取5.000g残留物后,经预处理后在容量瓶中配制成100mL溶液,移取25.00mL试样溶液,用1.000×10-2 mol/LKMnO4标准溶液滴定.达到滴定终点时,消耗标准溶液20.00mL,则残留物中铁元素的质量分数是 ____ .
参考答案与解析:
-
相关试题
-
()是四氯化硅氢还原法、三氯氢硅氢还原法、硅烷热分解法都要经历的步骤,且反应原理一致。
-
()是四氯化硅氢还原法、三氯氢硅氢还原法、硅烷热分解法都要经历的步骤,且反应原理一致。A. 加碳还原成粗硅B. 粗硅研磨成硅粉C. 热分解生成多晶硅D. 氢气还
- 查看答案
-
硅和氧很容易化合成二氧化硅,所以硅铁常用于炼钢作()。
-
[单选题]硅和氧很容易化合成二氧化硅,所以硅铁常用于炼钢作()。A .脱氧剂B .脱硫剂C .变性剂D .合金添加剂
- 查看答案
-
二氧化硅的含量高,硅砂的()也较高。
-
[填空题] 二氧化硅的含量高,硅砂的()也较高。
- 查看答案
-
硅灰按照二氧化硅含量分为( )级。
-
硅灰按照二氧化硅含量分为( )级。A. 85B. 88 |C. 90D. 92
- 查看答案
-
二氧化硅生长过程中,当分凝系数小于1时,会使二氧化硅-硅界面处硅一侧的杂质浓度(
-
[单选题]二氧化硅生长过程中,当分凝系数小于1时,会使二氧化硅-硅界面处硅一侧的杂质浓度()。A . 降低B . 增加C . 不变D . 先降低后增加
- 查看答案
-
热氧化过程中,硅内靠近Si-SiO2 界面的杂质将在界面两边的硅与二氧化硅中形成再分布。对于k<1、二氧化硅中的慢扩散杂质,再分布之后靠近界面处二氧化硅中的杂质浓度比硅中高,硅表面附近浓
-
热氧化过程中,硅内靠近Si-SiO2 界面的杂质将在界面两边的硅与二氧化硅中形成再分布。对于k<1、二氧化硅中的慢扩散杂质,再分布之后靠近界面处二氧化硅中的杂质
- 查看答案
-
热氧化过程中,硅内靠近Si-SiO2 界面的杂质将在界面两边的硅和二氧化硅中形成再分布。对于k<1、二氧化硅中的慢扩散杂质,再分布之后靠近界面处二氧化硅中的杂质浓度比硅中高,硅表面附近浓
-
热氧化过程中,硅内靠近Si-SiO2 界面的杂质将在界面两边的硅和二氧化硅中形成再分布。对于k<1、二氧化硅中的慢扩散杂质,再分布之后靠近界面处二氧化硅中的杂质
- 查看答案
-
二氧化硅膜能有效的对扩散杂质起掩蔽作用的基本条件有哪些() ①杂质在硅中的扩散系数大于在二氧化硅中的扩散系数 ②杂质在硅中的扩散系数小于在二氧化硅中的扩散系数 ③二氧化硅的厚度大于杂质在
-
二氧化硅膜能有效的对扩散杂质起掩蔽作用的基本条件有哪些() ①杂质在硅中的扩散系数大于在二氧化硅中的扩散系数 ②杂质在硅中的扩散系数小于在二氧化硅中的扩
- 查看答案
-
下列硅砂牌号中二氧化硅含量最高的是()。
-
[单选题]下列硅砂牌号中二氧化硅含量最高的是()。A . ZGS80-86H-90B . ZGS96-60Q-15C . ZGS85-42H-45D . ZGS93-42Q-30
- 查看答案
-
铸造用硅砂二氧化硅分级,如代号为98,表示二氧化硅最低含量为98%。
-
[主观题]铸造用硅砂二氧化硅分级,如代号为98,表示二氧化硅最低含量为98%。此题为判断题(对,错)。
- 查看答案